Минобрнауки России
федеральное государственное бюджетное образовательное учреждение
высшего профессионального образования
Санкт-Петербургский государственный технологический институт
(технический университет)
Факультет: Химии веществ и материалов
Кафедра: Физической химии
Технологии электрохимических производств
Учебная дисциплина: Введение в специальность
Курс 1 Группа 122
Реферат
Тема: Пленочные наноструктуры
Студент ____________ Шаповалов Вадим Владимирович
подпись
Преподаватели ассистент, Комлев А.А.
(Руководители) ассистент, Комлев А.А.
Оценка за работу
подпись преподавателя
Санкт-Петербург
2012
Содержание:
Введение………………………………………………………………………………………….3
Основная часть…………………………………………………………………………………...4
Тонкие пленки и их классификация………………………………………….………………...6
Термовакуумное напыление…………………………………………………………………….6
Ионно-плазменные методы получения тонких пленок………………………………………..8
Катодное распыление……………………………………………………………………..……10
Высокочастотное распыление…………………………………………………………………11
Магнетронное распыление……………………………………………………………………..13
Ионно-лучевые методы получения тонких пленок………………………………………......14
Молекулярно-лучевая эпитаксия……………………………………………………………...15
Лазерное распыление…………………………………………………………………………..16
Химические вакуумные методы……………………………………………………………….17
Реактивное катодное распыление……………………………………………………………..17
Жидкофазная эпитаксия………………………………………………………………………..18
Химические вневакуумные методы…………………………………………………………...19
Электрохимическое осаждение покрытий……………………………………………………19
Химическая металлизация……………………………………………………………………..20
Применение пленочных материалов…………………………………………………………..21
Заключение……………………………………………………………………………………...23
Список литературы……………………………………………………………………………..24
Приложение……………………………………………………………………………………..24
Введение.
Современный научно-технический прогресс в значительной степени определяется развитием электроники, основой которой являются успехи фундаментальных наук, в первую очередь химии твердого тела. Последние достижения в этой области связаны с химией наноструктур. На сегодняшний день химия наноструктур - актуальнейшая и наиболее динамично развивающаяся область современной химии твердого тела. Интерес к этой области связан как с принципиально новыми фундаментальными научными проблемами и физическими явлениями, так и с перспективами создания на основе уже открытых явлений совершенно новых устройств и систем с широкими функциональными возможностями для опто - и наноэлектроники, измерительной техники, информационных технологий нового поколения, средств связи и пр.
В последнее время интенсивно развиваются технологии создания композитных материалов. Одним из основных ее достоинств является возможность использования принципиально новых подходов в создании искусственных сред - наноматериалов. Эти материалы проявляют уникальные свойства, существенно отличающиеся от свойств вещества в макроскопическом (объемном) состоянии.
Среди основных составляющих науки о наноматериалах и нанотехнологиях можно выделить следующие: 1) фундаментальные исследования свойств материалов на наномасштабном уровне; 2) развитие нанотехнологий как для целенаправленного создания наноматериалов, так и поиска и использования природных объектов с наноструктурными элементами, создание готовых изделий с использованием наноматериалов и интеграция наноматериалов и нанотехнологий в различные отрасли промышленности и науки; 3) развитие средств и методов исследования структуры и свойств наноматериалов, а также методов контроля и аттестации изделий и полуфабрикатов для нанотехнологий.
Начало XXI века ознаменовалось революционным началом развития нанотехнологий и наноматериалов. Они уже используются во всех развитых странах мира в наиболее значимых областях человеческой деятельности (промышленности, обороне, информационной сфере, радиоэлектронике, энергетике, транспорте, биотехнологии, медицине). Анализ роста инвестиций, количества публикаций по данной тематике и темпов внедрения фундаментальных и поисковых разработок позволяет сделать вывод о том, что в ближайшие 20 лет использование нанотехнологий и наноматериалов будет являться одним из определяющих факторов научного, экономического и оборонного развития государств. Некоторые эксперты даже предсказывают, что XXI века будет веком нанотехнологий ( по аналогии с тем как XIX век называли веком пара, а XX век – веком атома и компьютера).
Основная часть
Пленочные наноструктуры.
Тонкие пленки находят широкое применение в различных областях науки и техники. Их роль в научно-техническом прогрессе чрезвычайно велика. Важнейшие задачи, решаемые пленочным материаловедением, - получение пленочных материалов с широким спектром свойств (электрофизических, механических), развитие методов синтезирования пленочных систем с наперед заданными свойствами.
Тонкие пленки - это особый вид состояния конденсированного вещества. По своей структуре и свойствам они могут существенно отличаться от своих массивных аналогов. Это обусловлено спецификой процесса их формирования: тонкие пленки получаются конденсацией молекулярных потоков вещества на поверхности твердого тела, называемого в этом случае подложкой.
Свойства тонких пленок являются производными их морфологии, атомной структуры, кристалличности и степени ее совершенства, которые, в свою очередь, определяются кинетикой процесса пленкообразования.
Тонкие пленки могут быть твердыми или жидкими (реже — газообразными). Состав, структура и свойства тонких пленок могут отличаться от таковых для объемной фазы, из которой образовалась тонкая пленка. К твердым тонким пленкам относятся оксидные пленки на поверхности металлов и искусственные пленочные покрытия, формируемые на различных материалах с целью создания приборов микроэлектроники, предотвращения коррозии, улучшения внешнего вида и т. п.
Жидкие тонкие пленки разделяют газообразную дисперсную фазу в пенах и жидкие фазы в эмульсиях; образование устойчивых пен и эмульсий возможно только при наличии ПАВ(поверхностно-активных в-в) в составе пленок. Жидкие тонкие пленки могут возникать самопроизвольно между зернами в поликристаллических твердых телах, если поверхностная энергия границы зерна превышает поверхностное натяжение на границе твердой и жидкой фаз более, чем вдвое (условие Гиббса–Смита). Газообразные тонкие пленки с заметным временем жизни могут возникнуть между каплей и объемной жидкостью в условиях испарения.
Определение толщины тонких пленок часто проводят методами, основанными на измерении интенсивности отраженного света, например, при помощи эллипсометрии; используют также электрические методы, основанные на определении емкости и проводимости тонких пленок. Для изучения твердых тонких пленок применяют электронную микроскопию, рентгеновскую спектроскопию и другие методы, разработанные для исследования поверхности твердых тел. Получение тонких пленок и тонкопленочных покрытий лежит в основе ряда современных областей техники, прежде всего микроэлектроники.
Тонкие пленки и их классификация.
Конденсированные объекты, в зависимости от их формы, геометрических размеров можно условно классифицировать на:
1) одномерные;
2) двухмерные;
3) трехмерные.
Одномерные объекты – микрочастицы конденсированной фазы (кластеры, островки, микрокапли), свойства которых зависят от их размера, по крайней мере, в 2-х направлениях.
Двухмерные - тонкие пленки и покрытия, свойства которых зависят от их размера в одном из направлений (толщины пленки или покрытия).
Трехмерные - твердые тела и жидкости в больших объемах, свойства которых не зависят от размеров тел. Например, плотность жидкости в ведре или стакане одинакова и поэтому жидкость в таком количестве следует рассматривать как трехмерный объект.
В зависимости от способа получения покрытий их разделяют на три группы:
1. Покрытия, формируемые из газовой фазы. В данную группу входят покрытия, осаждаемые из газовой фазы, генерация которой осуществляется, как правило, в результате:
а) ионного распыления вещества в вакууме;
б) испарения в вакууме;
в) проведения химических транспортных реакций;
г) пиролиза сложных химических соединений;
д) диспергирования полимеров или олигомеров в результате действия на них концентрированного потока энергии (электронов, ионов, электромагнитного излучения).
Образование покрытия происходит при взаимодействии частиц газовой фазы с поверхностью подложки.
2. Покрытия, формируемые из жидкой фазы. В эту группу входят:
а) лакокрасочные покрытия;
б) покрытия, образованные при монолитизации (затвердевании) расплавов вещества;
в) покрытия, осаждаемые из газокапельной фазы, например, методами плазменного, газопламенного, электродугового напыления;
г) пленки Лэнгмюра-Блоджет;
д) электролитические покрытия и т. д.
3. Покрытия, при осаждении которых в качестве исходного материала используются вещества в твердом состоянии. Они образуются, например, в результате припекания или приклеивания фольги, переноса вещества при трении и т. д.
В зависимости от природы материала различают следующие покрытия:
а) металлические;
б) полупроводниковые;
в) керамические;
г) полимерные;
е) композиционные, которые в свою очередь разделяют на однослойные, многослойные, комбинированные и т. д.
Процесс формирования тонких пленок является сложным процессом. Получение пленочных систем с заранее заданными свойствами связано с проблемой управления многими процессами, созданными при получении пленок. Ниже будут даны примеры получения пленочных наноструктур, их преимущества и недостатки:
Получение пленочных материалов:
Физические вакуумные методы
Физические методы осаждения различных материалов хорошо известны и достаточно подробно обсуждаются в научной литературе. Можно сказать, что все эти технологии возможны для получения оксидных пленок. Ниже приведен краткий обзор этих методов получения пленок в вакууме.
Термовакуумное напыление
Термовакуумный метод получения тонких пленок основан на нагреве в вакууме вещества до его активного испарения и конденсации испаренных атомов на поверхности подложки. К достоинствам метода осаждения тонких пленок термическим испарением относятся высокая чистота осаждаемого материала (процесс проводится при высоком и сверхвысоком вакууме), универсальность (наносят пленки металлов, сплавов, полупроводников, диэлектриков) и относительная простота реализации. Ограничениями метода являются нерегулируемая скорость осаждения, низкая, непостоянная и нерегулируемая энергия осаждаемых частиц.
Сущность метода термовакуумного напыления можно пояснить с помощью упрощенной схемы установки, представленной на рис.1.
Вещество, подлежащее напылению, помещают в устройство нагрева (испаритель) 1, где оно при достаточно высокой температуре интенсивно испаряется. В вакууме, который создается внутри камеры специальными насосами, молекулы испаренного вещества свободно и быстро распространяются в окружающее пространство, достигая, в частности, поверхности подложки 2. Если температура подложки не превышает критического значения, происходит конденсация вещества на подложке, то есть рост пленки. На начальном этапе испарения во избежание загрязнения пленки за счет примесей, адсорбированных поверхностью испаряемого вещества, а также для вывода испарителя на рабочую температуру используется заслонка 4, временно перекрывающая поток вещества на подложку. В зависимости от функционального назначения пленки в процессе осаждения контролируется время напыления, толщина, электрическое сопротивления или какой-либо другой параметр. По достижении заданного значения параметра заслонка вновь перекрывает поток вещества и процесс роста пленки прекращается. Нагрев подложки с помощью нагревателя 3 перед напылением способствует десорбции адсорбированных на ее поверхности атомов, а в процессе осаждения создает условия для улучшения структуры растущей пленки. Непрерывно работающая система откачки поддерживает вакуум порядка 10-4 Па.
Разогрев испаряемого вещества до температур, при которых оно интенсивно испаряется, осуществляют электронным или лазерным лучом, СВЧ-излучением, с помощью резистивных подогревателей (путем непосредственного пропускания электрического тока через образец из нужного вещества или теплопередачей от нагретой спирали). В целом метод отличается большим разнообразием как по способам разогрева испаряемого вещества, так и по конструкциям испарителей.
Если требуется получить пленку из многокомпонентного вещества, то используют несколько испарителей. Поскольку скорости испарения у различных компонентов разные, то обеспечить воспроизводимость химического состава получаемых многокомпонентных пленок довольно сложно. Поэтому метод термовакуумного напыления используют в основном для чистых металлов.
Весь процесс термовакуумного напыления можно разбить на три стадии: испарение атомов вещества, перенос их к подложке и конденсация. Испарение вещества с поверхности имеет место, вообще говоря, при любой температуре, отличной от абсолютного нуля. Если допустить, что процесс испарения молекул (атомов) вещества протекает в камере, стенки которой достаточно сильно нагреты и не конденсируют пар (отражают молекулы), то процесс испарения становится равновесным, то есть число молекул, покидающих поверхность вещества, равно числу молекул, возвращающихся в вещество. Давление пара, соответствующее равновесному состоянию системы, называется давлением насыщенного пара, или его упругостью.
Вторая стадия процесса напыления тонких пленок – перенос молекул вещества от испарителя к подложке. Если обеспечить прямолинейное и направленное движение молекул к подложке, то можно получить высокий коэффициент использования материала, что особенно важно при осаждении дорогостоящих материалов. При прочих равных условиях это повышает также и скорость роста пленки на подложке.
По мере испарения вещества интенсивность потока и диаграмма направленности для большинства типов испарителей постепенно меняются. В этих условиях последовательная обработка неподвижных подложек приводит к разбросу в значениях параметров пленки в пределах партии, обработанной за один вакуумный цикл. Для повышения воспроизводимости подложки устанавливаются на вращающийся диск-карусель. При вращении карусели подложки поочередно и многократно проходят над испарителем, за счет чего нивелируются условия осаждения для каждой подложки и устраняется влияние временной нестабильности испарителя. Третьей стадией процесса напыления тонких пленок является стадия конденсации атомов и молекул вещества на поверхности подложки. Эту стадию условно можно разбить на два этапа: начальный этап – от момента адсорбции первых атомов (молекул) на подложку до момента образования сплошного покрытия, и завершающий этап, на котором происходит гомогенный рост пленки до заданной толщины.
Ионно-плазменные методы получения тонких пленок
Ионно-плазменные методы получили широкое распространение в технологии электронных средств, благодаря своей универсальности и ряду преимуществ по сравнению с другими технологическими методами. Универсальность определяется тем, что с их помощью можно осуществлять различные технологические операции: формировать тонкие пленки на поверхности подложки, травить поверхность подложки с целью создания на ней заданного рисунка интегральной микросхемы, осуществлять очистку поверхности. К преимуществу ионно-плазменных методов относится высокая управляемость процессом; возможность получения пленок тугоплавких материалов, а также химических соединений и сплавов заданного состава; лучшая адгезия пленок к поверхности и так далее.
Суть методов ионно-плазменного напыления тонких пленок заключается в обработке поверхности мишени из нужного вещества ионами и выбивании атомов (молекул) из мишени. Энергия ионов при этом составляет величину порядка сотен и тысяч электрон-вольт. Образующийся атомный поток направляется на подложку, где происходит конденсация вещества и формируется пленка. Различают ионно-лучевое распыление, осуществляемое бомбардировкой мишени пучком ускоренных ионов, сформированным в автономном ионном источнике, и собственно ионно-плазменное распыление, при котором мишень является одним из электродов в газоразрядной камере и ее бомбардировка осуществляется ионами, образующимися в результате газового разряда.
Для распыления мишени используются ионы инертных газов (обычно аргон высокой чистоты). Источником ионов служит либо самостоятельный тлеющий разряд, либо плазма несамостоятельного разряда (дугового или высокочастотного). В настоящее время в производстве применяют различные процессы распыления, отличающиеся:
- характером питающего напряжения (постоянное, переменное, высокочастотное);
- способом возбуждения и поддержания разряда (автоэлектронная эмиссия, термоэмиссия, магнитное поле, электрическое высокочастотное поле);
- количеством электродов в газоразрядной камере (двухэлектродные, трехэлектродные и многоэлектродные системы).
Рассмотрим наиболее широко используемые ионно-плазменные методы получения тонких пленок.
1. Катодное распыление
Конструкция установки для катодного распыления, изображенной на рис. 2, состоит из газоразрядной камеры 1, в которую вводится рабочий газ (обычно аргон) под давлением 1 - 10 Па; катода 2, выполняющего функцию распыляемой мишени; анода 3 и закрепленной на ней подложки 4. Между анодом и катодом подается постоянное напряжение величиной несколько киловольт, обеспечивающее создание в межэлектродном пространстве электрического поля напряженностью порядка 0,5 кВ/см. Анод заземлен, а отрицательное напряжение к катоду подается через изолятор 5. Чтобы исключить загрязнение стеклянного колпака камеры, вблизи катода закрепляют экран 6.
Электрическое поле, существующее между катодом и анодом, ускоряет электроны, образующиеся в межэлектродном пространстве в результате фотоэмиссии из катода, автоэлектронной (полевой) эмиссии, воздействия космического излучения или других причин. Если энергия электронов превышает энергию ионизации молекул рабочего газа, то в результате столкновения электронов с молекулами газа возникает газовый разряд, то есть образуется газоразрядная плазма. Для того чтобы электрон мог набрать необходимую для ионизации газа энергию, ему требуется обеспечить минимально необходимую длину свободного пробега. Только при этом условии электрон, двигаясь без столкновений, способен увеличить свою энергию до нужной величины.
Однако, если длина свободного пробега электронов становится сравнимой с расстоянием между катодом и анодом, то основная часть электронов будет пролетать межэлектродное пространство без столкновений с молекулами рабочего газа. Газоразрядная плазма погаснет. Эти два фактора и определяют нижний и верхний пределы давлений газа в камере.
Образующаяся в результате газового разряда плазма состоит из электронов, ионов и нейтральных молекул рабочего газа. Ионы под воздействием электрического поля ускоряются и бомбардируют катод-мишень. Если энергия ионов превышает энергию связи атомов мишени, то происходит ее распыление. Кроме выбивания атомов с поверхности мишени, ионы способны выбить из нее вторичные электроны (вторичная электронная эмиссия). Эти вторичные электроны ускоряются и ионизируют молекулы рабочего газа; образующиеся при этом ионы бомбардируют мишень, вызывая вторичную электронную эмиссию, и процесс повторяется. Таким образом, газовый разряд поддерживает сам себя и поэтому называется самостоятельным тлеющим разрядом.
С повышением тока, протекающего через газоразрядную плазму, увеличивается плотность ионного потока и интенсивность распыления мишени. При некоторой плотности потока, зависящей от условий охлаждения мишени, начинает проявляться термоэлектронная эмиссия. Ток в разряде возрастает, а сам разряд становится несамостоятельным, приобретая характер дугового разряда.
Для предотвращения перехода самостоятельного тлеющего разряда в дуговой высоковольтный источник питания должен иметь ограничения по мощности, а мишень интенсивно охлаждаться.
Для описания процессов катодного распыления мишени используют модели, основанные на двух механизмах. Согласно первому механизму распыленные атомы возникают в результате сильного локального разогрева поверхности мишени самим падающим ионом (модель "горячего пятна") или быстрой вторичной частицей (модель "теплового клина"). Второй механизм состоит в передаче импульса падающего иона атомам решетки материала мишени, которые, в свою очередь, могут передать импульс, другим атомам решетки, вызвав тем самым каскад столкновений (модель столкновений).
Основной характеристикой эффективности процесса распыления является коэффициент распыления Кр, определяемый отношением количества выбитых атомов Nат к количеству бомбардирующих мишень ионов Nион:

По существу коэффициент распыления представляет собой среднее число атомов мишени, выбитых одним ионом. Коэффициент распыления зависит от энергии ионов Еи, его массы (рода рабочего газа), материала мишени и в некоторой степени от ее температуры и состояния поверхности, угла бомбардировки, давления газа (при условии, что давление не выходит за пределы, при которых газоразрядная плазма гаснет).
2. Высокочастотное распыление
Рассмотренные выше методы получения тонких пленок используют постоянные напряжения, прикладываемые к электродам системы распыления мишени. Это позволяет распылять мишени только из электропроводящих или полупроводниковых материалов. Если мишень выполнена из диэлектрика, то при ее бомбардировке положительно заряженными ионами на ней очень быстро будет накапливаться положительный заряд. Этот заряд создаст электрическое поле, которое будет тормозить бомбардирующие мишень ионы. Распыление мишени очень быстро прекратится.
Для распыления диэлектрической мишени необходимо между анодом и катодом-мишенью подавать переменное напряжение. В этом случае мишень поочередно будет обрабатываться потоками электронов и положительно заряженных ионов. При отрицательном потенциале на мишени будет происходить ее распыление ионами, а при положительном потенциале – нейтрализация заряда потоком электронов. Это в принципе позволяет распылять мишени из диэлектрических материалов, однако эффективность такого метода распыления будет невысокой.
Эффективность распыления можно значительно повысить, если между анодом и катодом-мишенью подать переменное напряжение частотой порядка 10 МГц (обычно используют частоту 13,56 МГц, разрешенную для технологических установок, работающих в этом частотном диапазоне). Повышение эффективности при высокочастотном распылении объясняется следующим образом. Масса электронов значительно меньше массы ионов. Поэтому, обладая значительно большей подвижностью, электроны успевают следовать за быстроменяющимся полем, переходя с одного электрода на другой. Ионы, будучи гораздо менее подвижными, не успевают заметно перемещаться в межэлектродном пространстве, в результате чего там образуется объемный положительный заряд ионов. Кроме того, количество электронов, поступающих на мишень за полпериода, значительно превышает то количество, которое необходимо для нейтрализации заряда ионов на мишени. В результате на диэлектрической мишени скапливается отрицательный заряд электронов. Все это приводит к появлению в межэлектродном пространстве дополнительного электрического поля, которое способно ускорить часть ионов до больших энергий, что и увеличивает эффективность распыления мишени.
Следует отметить еще одно важное обстоятельство. В условиях высокочастотного разряда заряженные частицы (электроны и ионы) совершают колебательное движение с амплитудой А, равной

где m - подвижность частицы, зависящая от давления газа; Е0 – амплитуда напряенности переменного электрического поля; w - циклическая частота питающего напряжения.
Благодаря пониженному давлению в газоразрядной камере, высокочастотные системы с успехом используют для распыления не только диэлектрических мишеней, но и мишеней из металлов и полупроводников.
3. Магнетронное распыление
Стремление снизить давление рабочего газа в камере и увеличить скорость распыления мишеней привело к созданию метода магнетронного распыления. Один из возможных вариантов схем магнетронного распылителя представлен на рис. 3.
Отличительной особенностью магнетронного распылителя является наличие двух скрещенных полей – электрического и магнитного.
Если из мишени-катода будет испускаться электрон (за счет вторичной электронной эмиссии), то траектория его движения будет определяться действием на него этих полей. Под воздействием электрического поля электрон начнет двигаться к аноду. Действие магнитного поля на движущийся заряд приведет к возникновению силы Лоренца, направленной перпендикулярно скорости. Суммарное действие этих сил приведет к тому, что в результате электрон будет двигаться параллельно поверхности мишени по сложной замкнутой траектории, близкой к циклоиде.
Важным здесь является то, что траектория движения замкнутая. Электрон будут двигаться по ней до тех пор, пока не произойдет несколько столкновений его с атомами рабочего газа, в результате которых произойдет их ионизация, а сам электрон, потеряв скорость, переместиться за счет диффузии к аноду. Таким образом, замкнутый характер траектории движения электрона резко увеличивает вероятность его столкновения с атомами рабочего газа. Это означает, что газоразрядная плазма может образовываться при значительно более низких давлениях, чем в методе катодного распыления. Значит и пленки, полученные методом магнетронного распыления, будут более чистыми. Другое важное преимущество магнетронных систем обусловлено тем, что ионизация газа происходит непосредственно вблизи поверхности мишени. Газоразрядная плазма локализована вблизи мишени, а не "размазана" в межэлектродном пространстве, как в методе катодного распыления. В результате резко возрастает интенсивность бомбардировки мишени ионами рабочего газа, тем самым увеличивается скорость распыления мишени и, как следствие, скорость роста пленки на подложке (скорость достигает несколько десятков нм/с). Наличие магнитного поля не дает электронам, обладающим высокой скоростью, долететь до подложки, не столкнувшись с атомами рабочего газа. Поэтому подложка не нагревается вследствие бомбардировки ее вторичными электронами. Основным источником нагрева подложки является энергия, выделяемая при торможении и конденсации осаждаемых атомов вещества мишени, в результате чего температура подложки не превышает 100 - 200 °С. Это дает возможность напылять пленки на подложки из материалов с малой термостойкостью (пластики, полимеры, оргстекло и так далее).
Ионно-лучевые методы получения тонких пленок
Тонкие пленки различных материалов можно наносить на подложку, распыляя материал мишени пучком ионов инертных газов. Основные достоинства этого метода нанесения пленок по сравнению с методом ионно-плазменного распыления состоят в следующем:
- возможность нанесения пленок материалов сложного состава с сохранением компонентного состава мишени;
- малое рабочее давление в технологической камере, ограниченное лишь быстротой откачки вакуумной системы, а не условиями поддержания разряда;
- отсутствие электрических полей в области подложки, что особенно важно при нанесении диэлектрических пленок на подложки из проводящих материалов;
- возможность управления зарядами в осаждаемой диэлектрической пленке с помощью электронов, эмиттируемых катодом нейтрализации.
Ионно-лучевой метод наиболее эффективен для нанесения пленок многокомпонентных материалов, различных диэлектриков, магнитных материалов.
Установка ионно-лучевого распыления представлена на рис.4.
Установка содержит источник ионов на основе двухкаскадного самостоятельного разряда с холодным полым катодом 1 и модифицированный вариант источника ионов Кауфмана с открытым торцом 2. Источник ионов 1 служит для распыления пучком ионов аргона с энергией 0,8 кэВ и плотностью тока 0,3 мА/см2 мишени 3 чистотой не хуже 99,8%. По направлению потока распыляемого материала установлены подложки, закрепленные на четырех позициях вращающегося держателя 4. Поток ионов аргона со средней энергий 80 эВ и плотностью тока 0,45 мА/см2 из источника ионов 2 служит для очистки и активации поверхности рабочей подложки в течение 2 минут перед нанесением пленки. Источник ионов 2 во время нанесения пленки отключается, подача аргона через него прекращается, а термокатод используется для нагрева поверхности рабочей подложки.
Молекулярно-лучевая эпитаксия
В настоящее время существуют два основных технологических метода эпитаксии, позволяющие формировать многослойные структуры со сверхтонкими слоями. Это молекулярно-лучевая (МЛЭ) и газофазная эпитаксия, в том числе с использованием металлоорганических соединений (МОС) и гидридов (ГФЭ МОС).
Молекулярно-лучевая эпитаксия проводится в вакууме и основана на взаимодействии нескольких молекулярных пучков с нагретой монокристаллической подложкой.
Основными преимуществами метода являются: низкая температура процесса и высокая точность управления уровнем легирования. Снижение температуры процесса уменьшает диффузию примеси из подложки и автолегирование. Это позволяет получать качественные тонкие слои. Легирование при использовании данного метода является безинерционным (в отличие эпитаксии из газовой фазы), что позволяет получать сложные профили легирования.
МЛЭ заключается в осаждении испаренных элементарных компонентов на подогретую монокристаллическую подложку. Этот процесс иллюстрируется с помощью рис. 5, на котором приведены основные элементы для получения соединения (GaAs).
Каждый нагреватель содержит тигель, являющийся источником одного из составных элементов пленки. Температура нагревателей подбирается таким образом, чтобы давление паров испаряемых материалов было достаточным для формирования соответствующих молекулярных пучков. Испаряемое вещество с относительно высокой скоростью переносится на подложку в условиях вакуума. Нагреватели располагаются так, чтобы максимумы распределений интенсивности пучков пересекались на подложке.
Подбором температуры нагревателей и подложки получают пленки со сложным химическим составом. Дополнительное управление процессом наращивания осуществляется с помощью заслонок, расположенных между нагревателем и подложкой. Использование этих заслонок позволяет резко прерывать или возобновлять попадание любого из молекулярных пучков на подложку.
Лазерное испарение
Лазерное напыление – уникальный технологический процесс, позволяющий наносить на поверхность деталей обладающие специальными свойствами материалы (металлы, карбиды и т.п.), добиваясь, таким образом, восстановления геометрии, повышения поверхностной прочности, коррозионной устойчивости, снижения трения и прочих эффектов. В отличие от технологии, использующей тепло электрической дуги или сгорания смеси горючего и кислорода, лазерное напыление обеспечивает меньшее термическое воздействие и смешивание материала подложки с напыляемым материалом, при более прочном их скреплении.
Схема установки лазерным испарением представлена на рис. 6.
Глубина проникновения лазерного луча в поверхность мишени мала (приблизительно 10 нм). Это означает, что только тонкий поверхностный слой материала подвержен воздействию излучения в то время, как оставшаяся часть мишени остается незатронутой.
Говоря о достоинствах лазерного распыления, можно отметить, что это один из наиболее быстрых методов получения тонкопленочных покрытий, он предоставляет четко ориентированное направление распространения плазмы, наряду со стехиометрическим трансфером материи от мишени к подложке.
Химические вакуумные методы
Метод химического осаждения тонких пленок осуществляется при напуске в рабочую камеру смеси газов, содержащей компоненты получаемой пленки. Главными преимуществами метода химического осаждения являются широкий диапазон скоростей осаждения и возможность получения заданной кристаллической структуры пленки (вплоть до монокристаллов), а основным недостатком — использование токсичных, экологически небезопасных газовых смесей.
Реактивное катодное распыление
В отличие от физического распыления реактивное катодное распыление происходит в тлеющем разряде смеси инертного и активного газов. Частицы распыленного катода химически взаимодействуют с активным газом или образуют с ним твердые соединение, и новое вещество попадает в основу. Чтобы процесс образования вещества пленки, которая наносится, не проходил на катоде, что очень усложняет горения разряда, применяют смеси аргона с содержанием активных газов не более 10%. Для получения пленок оксидов распыления проводят в плазме аргон-кислород, нитрид - в плазме аргон-азот, карбидов в плазме аргон-угарный газ или аргон-метан. При вводе в камеру различных активных газов, получают пленки различных соединений, которые практически невозможно получить термовакуумным напылением.
Реактивное катодное распыление позволяет не только получить различные по составу пленки, но и управлять их свойствами, например удельное сопротивление резистивных пленок. Реактивное распыление широко используется для формирования высокоомных резисторов.
Главными техническими трудностями при реактивном катодном распылении является точное дозирование активного газа, подаваемого в вакуумную камеру.
Жидкофазная эпитаксия
Жидкофазная эпитаксия в основном применяется для получения многослойных полупроводниковых соединений, таких как GaAs, CdSnP2. Готовится шихта из вещества наращиваемого слоя, легирующей примеси (может быть подана и в виде газа) и металла-растворителя, имеющего низкую температуру плавления и хорошо растворяющий материал подложки (Ga, Sn, Pb). Процесс проводят в атмосфере азота и водорода (для восстановления оксидных плёнок на поверхности подложек и расплава) или в вакууме (предварительно восстановив оксидные плёнки). Расплав наносится на поверхность подложки, частично растворяя её, и удаляя загрязнения и дефекты. После выдержки при максимальной температуре ≈ 1000°С начинается медленное охлаждение. Избытки полупроводника осаждаются на подложку, играющую роль затравки. Существуют три типа контейнеров для проведения эпитаксии из жидкой фазы: вращающийся (качающийся), пенального типа, шиберного типа.
Химические вневакуумные методы
Электрохимическое осаждение покрытий
Это метод получения пленок отличается от предыдущих тем, что рабочей средой является жидкость. Однако характер процессов сходен с ионно-плазменным напылением, поскольку и плазма, и электролит представляют собой квазинейтральную смесь ионов и неионизированных молекул или атомов. А главное, осаждение происходит также постепенно (послойно) как и напыление, т.е. обеспечивает возможность получения тонких пленок.
В основе электрохимического осаждения лежит электролиз раствора, содержащего ионы необходимых примесей. Например, если требуется осадить медь, используется раствор медного купороса, а если золото или никель – растворы соответствующих солей.
Ионы металлов дают в растворе положительный заряд. Поэтому, чтобы осадить металлическую пленку, подложку следует использовать как катод. Если подложка является диэлектриком или имеет низкую проводимость, на нее предварительно наносят тонкий металлический подслой, который и служит катодом. Подслой можно нанести методом термического или ионно-плазменного напыления.
Большое преимущество электрохимического осаждения перед напылением состоит в гораздо большей скорости процесса, которая легко регулируется изменением тока. Поэтому основная область применения электролиза в микроэлектронике – это получение сравнительно толстых пленок (10 – 20 мкм и более). Качество (структура) таких пленок хуже, чем при напылении, но для ряда применений они оказываются вполне приемлемыми.
Один из вариантов химического ионно-плазменного напыления называют анодированием. Этот процесс состоит в окислении поверхности металлической пленки (находящейся под положительным потенциалом) отрицательными ионами кислорода, поступающими из плазмы газового разряда. Для этого к инертному газу (как и при чисто химическом напылении) следует добавить кислород. Т. о., анодирование осуществляется не нейтральными атомами, а ионами.
Химическое напыление и анодирование проходят совместно, т.к. в газоразрядной плазме (если она содержит кислород) сосуществуют нейтральные атомы и ионы кислорода. Для того чтобы анодирование превалировало над чисто химическим напылением, подложку располагают "лицом" (т.е. металлической пленкой) в сторону, противоположную катоду, с тем, чтобы на нее не попадали нейтральные атомы.
По мере нарастания окисного слоя ток в анодной цепи падает, т. к. окисел является диэлектриком. Для поддержания тока нужно повышать питающее напряжение. Поскольку часть этого напряжения падает на пленке, процесс анодирования протекает в условиях большой напряженности поля в окисной пленке. В результате и в дальнейшем она обладает повышенной электрической прочностью.
К числу других преимуществ анодирования относятся большая скорость окисления и возможность управления процессом путем изменения тока в цепи разряда. Качество оксидных пленок, получаемых данным методом, выше, чем при использовании других методов.
Химическая металлизация
Химическая металлизация основана на химической "реакции серебряного зеркала" и заключается в нанесении на поверхности пластмасс, пластика, алюминия, керамики металлизируемых изделий зеркальных металлических покрытий, которые имеют высокую отражающую способность. Зеркальные металлизированные поверхности, образующиеся в результате химической металлизации, отличаются целым рядом существенных преимуществ. Во-первых, такой метод как химическая металлизация практична с экономической точки зрения. Он не является технически сложным и оптимально вписывается в технологические процессы. Во-вторых, металлизация универсальна. В-третьих, металлизированные поверхности, получаемые с применением метода, как химическая металлизациия, отличаются прекрасными механическими свойствами, в частности высокой износостойкостью и твердостью. В-четвертых, химическая металлизация удобна тем, что размеры металлизируемых деталей практически не ограниченны. В-пятых, такой процесс как химическая металлизация совершенно безвреден в экологическом отношении, он не наносит ущерба здоровью людей и окружающей среде.
При использовании метода химической металлизации технологический процесс осуществляется в три основных этапа. Сначала на поверхность детали наносится слой специального связующего грунта, активного по отношению к последующему металлическому слою. Затем при помощи установки "Мета-хром", предназначенной для химической металлизации пластмасс, на покрытую связующим грунтом поверхность напыляют специально подготовленные химреагенты, которые в результате химической реакции и образуют на поверхности детали зеркальное металлическое покрытие. Наконец, на полученное зеркальное покрытие наносится слой защитного лака, предохраняющий металлизированную поверхность от потускнения и механического износа. После затвердения и высыхания защитного лака металлизированное покрытие выглядит точно так же, как если бы оно было нанесено методом электролитического осаждения. Добавляя в защитный лак красящие пигментные тонеры, можно придать покрытию внешний вид хрома, алюминия, золота, меди, бронзы, других металлов и сплавов.
Применение пленочных материалов
В настоящее время на производственных предприятиях микроэлектронной промышленности выявляется потребность в нанесении тонких металлических и диэлектрических пленок на различные поверхности. Тонкие пленки широко применяются в качестве упрочняющих, светоотражающих, проводящих и диэлектрических покрытий. Чаще всего данные виды работ ведутся в НИИ для получения и исследования новых перспективных материалов, как для микроэлектронной промышленности, так и для устройств наноэлектроники.
С тонкими плёнками связаны такие явления, как технологии получения высокого вакуума, процессы и различные механизмы формирования пленок, многокомпонентные системы, технологические аспекты напыления, методы исследований, получения подложек и др. Исследование данных объектов имеет решающее значение для совершенствования микроэлектронных устройств и для науки в целом.
Самое простое применение тонких пленок — декоративное — создание зеркал и покрытий для ювелирных изделий. Также применяется в создании светофильтров, отражающих и светопроводящих покрытий оптоэлектроники; современных литографических процессах.
Например, такой вид органических пленок, как «Фибринные» используются в медицине для лечения: Фибринные пленки — как гетерогенные (из крови рогатого скота), так и гомогенные (из крови доноров) нашли широкое применение в хирургической практике при лечении ожогов, лучевых поражений наружных покровов, поражений кожи от рентгеновского облучения, вялогранулирующих ран, в стоматологической практике при ожогах полости рта и лица, в нейрохирургии при операциях на головном мозге и периферических нервах c целью предотвращения грубых рубцовых изменений и многих других повреждениях.
Или, если правильно подобрать толщину полиэтиленовой пленки, можно создать теплицы, способные защитить урожай даже при очень низкой температуре воздуха. Уже есть виды изделий, стойких при - 80ºС. Новые сорта парниковых пленок остаются эластичными под влиянием мороза и обладают хорошей стойкостью к механическим и ветровым воздействиям. Удерживать тепло внутри парника такому материалу позволяет коэффициент теплового пропускания в 10-40 %.
Заключение
Уменьшение геометрических размеров их элементов - один из современных способов модификаций изделий машиностроения и приборостроения. Многие из них включают в себя тонкопленочные покрытия, характеристики которых можно менять, варьируя их толщину. По функциональному назначению такие покрытия связаны практически со всеми разделами физики: механикой, электричеством, магнетизмом, оптикой, а в качестве материалов для них используется большинство элементов Периодической системы. Пленки используются также в медицине (антибактериальные покрытия хирургических инструментов), легкая промышленность (водоотталкивающие и антистатические покрытия тканей), машиностроение (коррозионно - и износостойкие покрытия деталей машин) и т.д.
В отраслях промышленности, производящих электронные, в том числе микроэлектронные устройства, используют разнообразные технологические процессы, в которых исходные материалы и полуфабрикаты преобразуются в сложные изделия, выполняющие различные радио-, опто- или акустоэлектрические функции. При изготовлении всех видов полупроводниковых приборов и ИМС в том или ином объеме используется технологический процесс нанесения тонких пленок в вакууме – тонкопленочная технология.
У исследователей, заинтересовавшихся в исследовании тонких пленок, имеется широкий выбор методов их изготовления. В общем случае, эти методы могут быть разбиты на два класса. Один класс объединяет методы, основанные на физическом испарении или распылении материала из источника, например термическое испарение или ионное распыление. В другом классе собраны методы, основанные на использовании химических реакций.
После рассмотрения различных методов получения тонких пленок сделан вывод, что нет оптимального выбора метода получения тонких пленок. Выбор метода зависит от типа требуемой пленки, от ограничений в выборе подложек и часто, особенно в случае многократного осаждения, от общей совместимости различных процессов, протекающих при применении этого метода.
Список использованной литературы:
1.Аксенова Н.И., Харенко А.В., Кеменова В.А. Гранулирование композиционного полимерного носителя КПН-2 в "псевдоожиженном слое" // Тез. докл. 2 Росс. нац. конгресса "Человек и лекарство" М.: Фармединфо, 1996.
2.В.М.Федосюк, А.М.Данилевский, С.К.Гордеев. Магнитные свойства
кластеров никеля в нанопористом углероде. // Физика Твердого Тела,
2003, №9.
3.Журнал «наноматериалы и наноструктуры — XXI век»
4.Ландау Л.Д., Лифшиц М.Ш. Теория упругости. М.: Наука. - Т.7. -1985. 283с.
5.www.wikipedia.org
6. Андриевский Р.А. Наноструктурные материалы, 2005.
7. Ремпель А.А. Нанотехнологии, свойства и применение наноструктурированных материалов, 2007.
Приложение
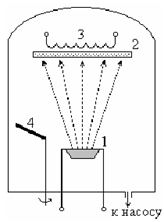
Рис. 1 Схема установки термовакуумного испарения

Рис. 2 Схема установки для катодного распыления

Рис. 3 Схема установки для магнетронного распыления

Рис. 4 Схема установки ионно-лучевого распыления

Рис. 5 Схема установки молекулярно-лучевой эпитаксии

Рис. 6 Схема установки лазерным испарением.














 (zip - application/zip)
(zip - application/zip)










